
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Дислокация в кристали SiC
SiC субстратът може да има микроскопични дефекти, като дислокация на винта с резба (TSD), дислокация на ръба на резбата (TED), дислокация на основната равнина (BPD) и други. Тези дефекти са причинени от отклонения в подреждането на атомите на атомно ниво.
SiC кристалите обикновено растат по начин, който се простира успоредно на оста c или под малък ъгъл с нея, което означава, че c-равнината е известна също като базова равнина. Има два основни вида дислокации в кристала. Когато линията на дислокация е перпендикулярна на основната равнина, кристалът наследява дислокации от зародишния кристал в епитаксиално израсналия кристал. Тези дислокации са известни като проникващи дислокации и могат да бъдат категоризирани като дислокации с резбови ръбове (TED) и дислокации с резбови винтове (TSD) въз основа на ориентацията на вектора на Бернули спрямо линията на дислокация. Дислокациите, при които както линиите на дислокация, така и векторите на Brönsted са в базовата равнина, се наричат дислокации на базовата равнина (BPD). Кристалите SiC могат също да имат съставни дислокации, които са комбинация от горните дислокации.
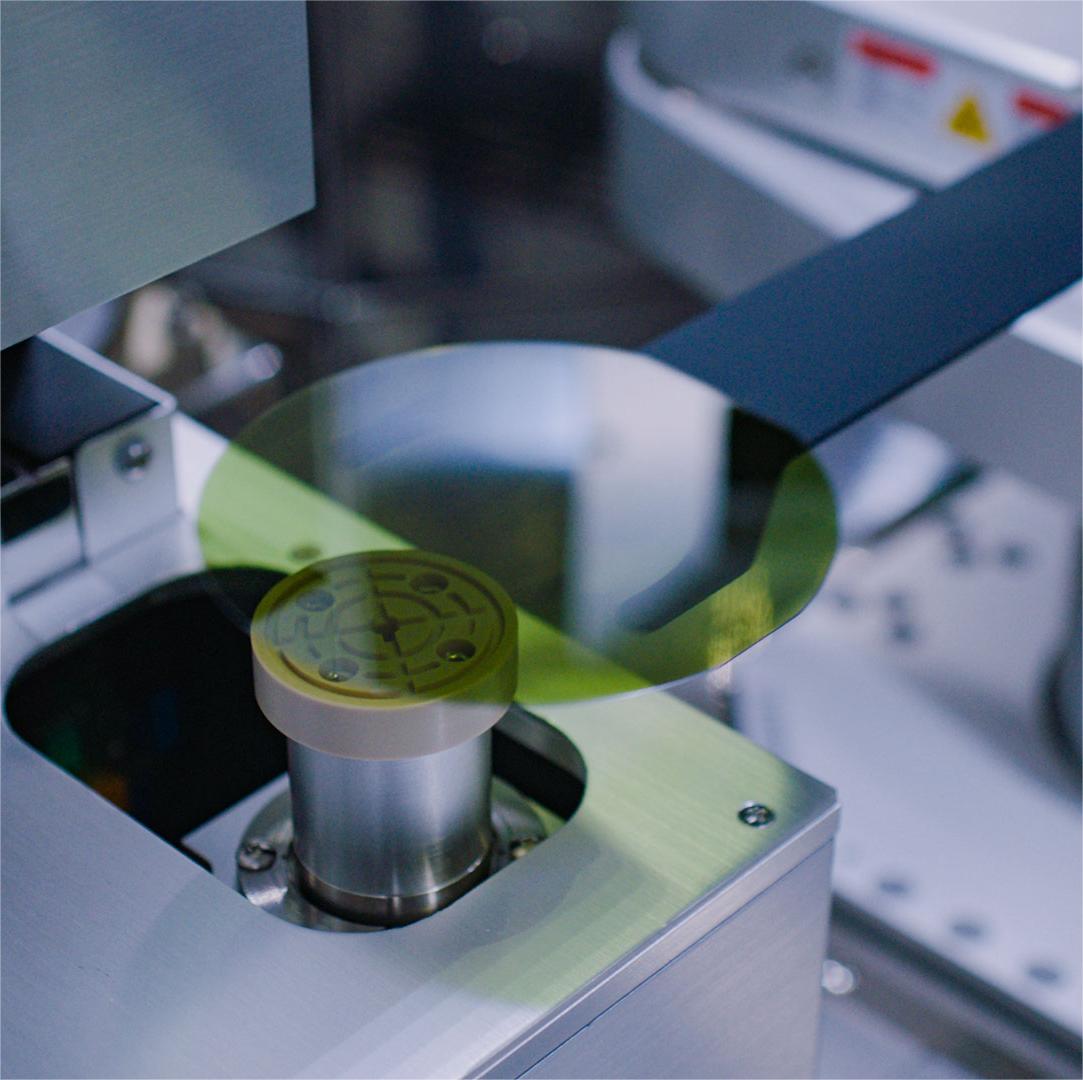
1. TED&TSD
И двете резбови дислокации (TSDs) и резбови ръбови дислокации (TEDs) се движат по протежение на [0001] оста на растеж с различни вектори на Burgers от <0001> и 1/3<11-20>, съответно.
Както TSD, така и TED могат да се простират от субстрата до повърхността на пластината и да създават малки повърхностни елементи, подобни на ями. Обикновено плътността на TED е около 8 000-10 000 1/cm2, което е почти 10 пъти по-голяма от тази на TSD.
По време на процеса на епитаксиален растеж на SiC, TSD се простира от субстрата до епитаксиалния слой на разширения TSD може да се трансформира в други дефекти в равнината на субстрата и да се разпространява по оста на растеж.
Показано е, че по време на епитаксиален растеж на SiC, TSD се трансформира в дефекти на слоя за подреждане (SF) или дефекти на моркови в равнината на субстрата, докато TED в епитаксиалния слой е показано, че се трансформира от BPD, наследен от субстрата по време на епитаксиален растеж.
2. BPD
Базалните равнинни дислокации (BPDs), които са разположени в [0001] равнината на SiC кристалите, имат вектор на Burgers от 1/3 <11-20>.
BPD рядко се появяват на повърхността на SiC пластини. Те обикновено са концентрирани върху субстрата при плътност от 1500 1/cm2, докато тяхната плътност в епитаксиалния слой е само около 10 1/cm2.
Разбираемо е, че плътността на BPD намалява с увеличаване на дебелината на SiC субстрата. Когато се изследват с помощта на фотолуминесценция (PL), BPD показват линейни характеристики. По време на процеса на епитаксиален растеж на SiC, разширеният BPD може да се трансформира в SF или TED.
От горното е очевидно, че има дефекти в подложката на SiC субстрата. Тези дефекти могат да бъдат наследени в епитаксиалния растеж на тънки филми, което може да причини фатална повреда на SiC устройството. Това може да доведе до загуба на предимствата на SiC като силно поле на пробив, високо обратно напрежение и нисък ток на утечка. Освен това, това може да намали степента на квалификация на продукта и да създаде огромни пречки пред индустриализацията на SiC поради намалената надеждност.




