
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe и Si технология за селективно ецване
Gate-All-Around FET (GAAFET), като транзисторна архитектура от следващо поколение, готова да замени FinFET, привлече значително внимание заради способността си да осигурява превъзходен електростатичен контрол и подобрена производителност при по-малки размери. Критична стъпка в производството на n-тип GAAFETs включва висока селективностофортот SiGe:Si стекове преди отлагането на вътрешни дистанционни елементи, генериране на силициеви нанолистове и освобождаващи канали.

Тази статия разглежда селективнототехнологии за ецванеучаства в този процес и въвежда два нови метода за ецване - ецване без плазма с високо оксидативен газ и ецване на атомен слой (ALE) - които предлагат нови решения за постигане на висока прецизност и селективност при ецване на SiGe.
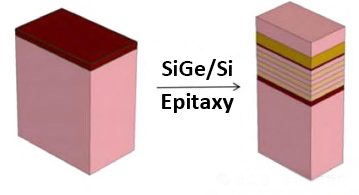
SiGe суперрешетъчни слоеве в GAA структури
При проектирането на GAAFET, за да се подобри производителността на устройството, се използват редуващи се слоеве Si и SiGeепитаксиално отгледан върху силиконов субстрат, образувайки многослойна структура, известна като суперрешетка. Тези SiGe слоеве не само регулират концентрацията на носителя, но също така подобряват мобилността на електроните чрез въвеждане на напрежение. Въпреки това, в следващите етапи на процеса, тези SiGe слоеве трябва да бъдат прецизно отстранени, като същевременно се запазят силициевите слоеве, което изисква високо селективни технологии за ецване.
Методи за селективно ецване на SiGe
Гравиране без плазма със силно окислителен газ
Избор на газ ClF3: Този метод на ецване използва силно окислителни газове с изключителна селективност, като ClF3, постигайки съотношение на селективност SiGe:Si от 1000-5000. Може да бъде завършен при стайна температура, без да причинява увреждане на плазмата.
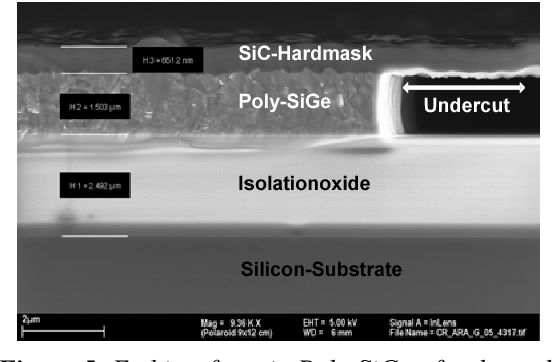
Нискотемпературна ефективност: Оптималната температура е около 30°C, реализирайки високоселективно ецване при ниски температурни условия, като се избягват допълнителни увеличения на топлинния бюджет, което е от решаващо значение за поддържане на производителността на устройството.
Суха среда: Цялатапроцес на ецванесе извършва при напълно сухи условия, елиминирайки риска от залепване на структурата.
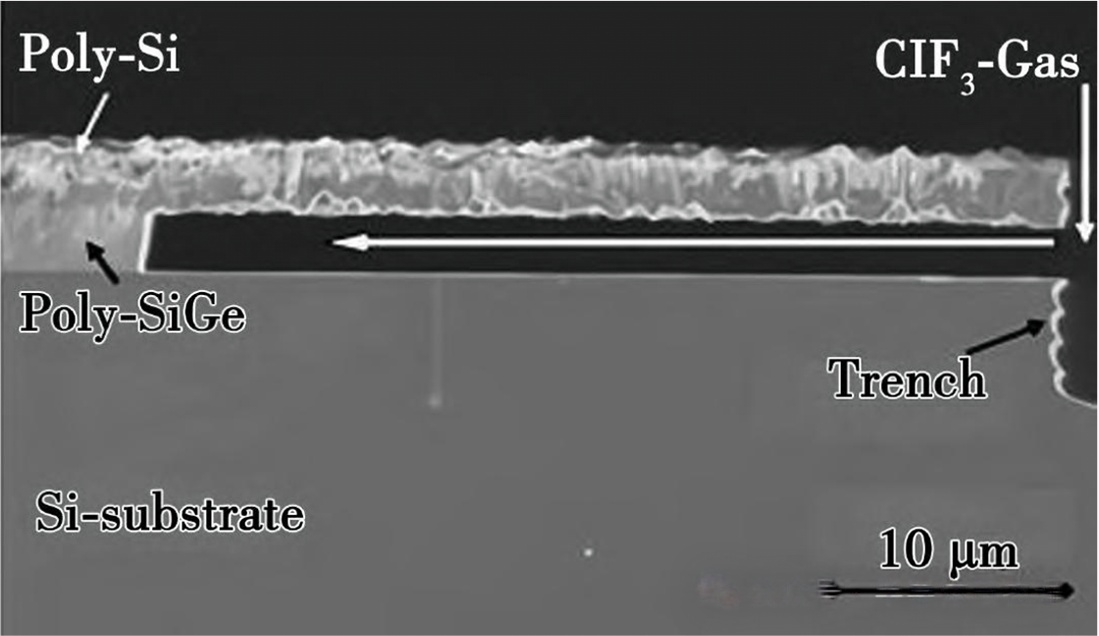
Гравиране на атомен слой (ALE)
Самоограничаващи се характеристики: ALE е двустепенен цикличентехнология за ецване, където повърхността на материала, който ще бъде гравиран, първо се модифицира и след това модифицираният слой се отстранява, без да се засягат немодифицираните части. Всяка стъпка е самоограничаваща се, осигуряваща прецизност до нивото на премахване само на няколко атомни слоя наведнъж.
Циклично ецване: Гореспоменатите две стъпки се повтарят многократно, докато се постигне желаната дълбочина на ецване. Този процес позволява на ALE да постигнепрецизно гравиране на атомно нивов малки кухини по вътрешните стени.

Ние от Semicorex сме специализирани вГрафитни разтвори с покритие от SiC/TaCприлагани в процесите на ецване в производството на полупроводници, ако имате запитвания или се нуждаете от допълнителни подробности, моля, не се колебайте да се свържете с нас.
Телефон за връзка: +86-13567891907
Имейл: sales@semicorex.com




