
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe в производството на чипове: Професионален новинарски доклад
Еволюцията на полупроводниковите материали
В областта на съвременната полупроводникова технология безмилостният стремеж към миниатюризация разшири границите на традиционните материали на базата на силиций. За да отговори на изискванията за висока производителност и ниска консумация на енергия, SiGe (силициев германий) се появи като предпочитан композитен материал в производството на полупроводникови чипове поради своите уникални физически и електрически свойства. Тази статия се задълбочава впроцес на епитаксияна SiGe и неговата роля в епитаксиалния растеж, напрегнати силициеви приложения и Gate-All-Around (GAA) структури.
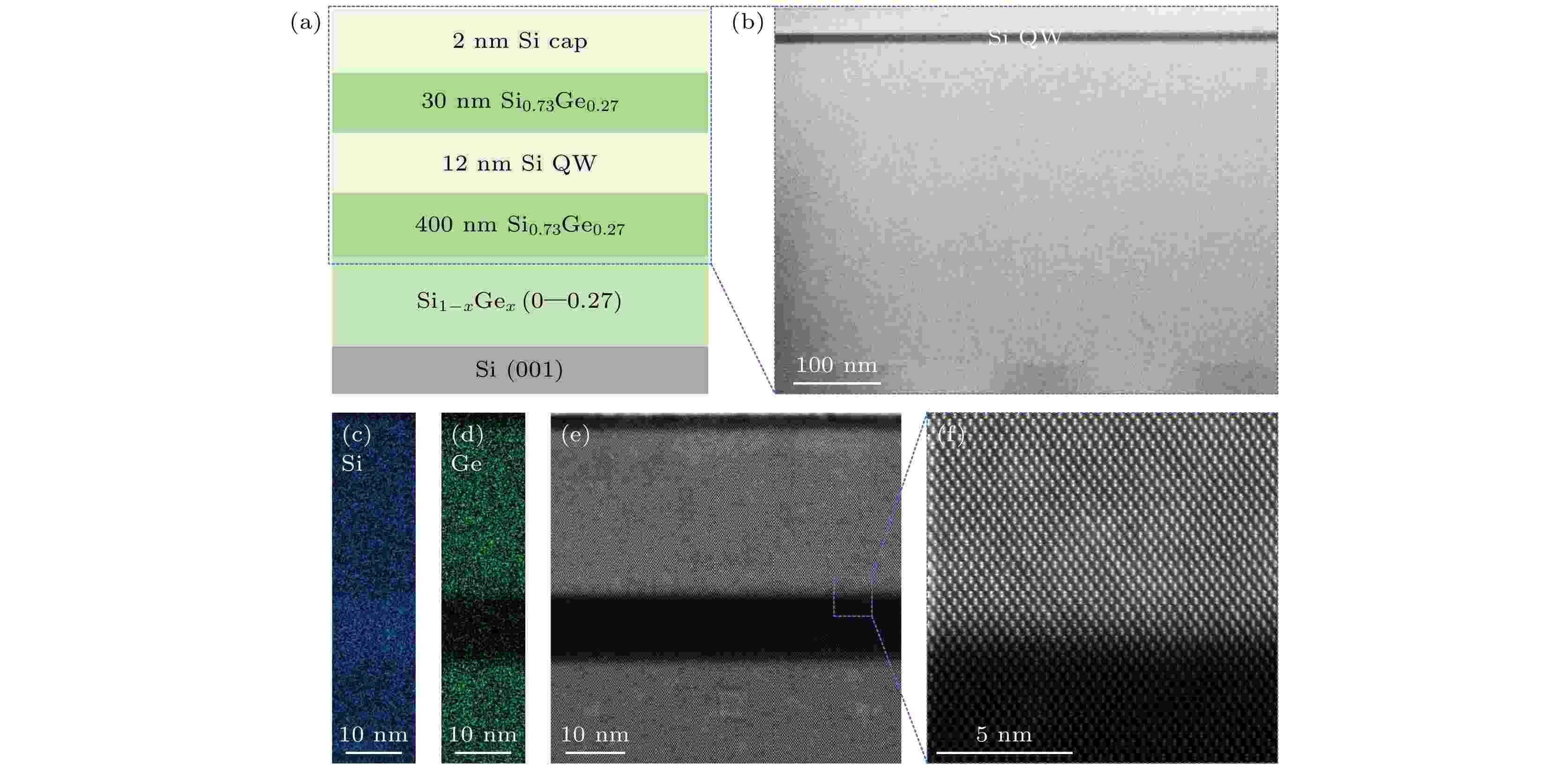
Значението на SiGe епитаксия
1.1 Въведение в епитаксията в производството на чипове:
Епитаксията, често съкратена като Epi, се отнася до растежа на монокристален слой върху монокристален субстрат със същото разположение на решетката. Този слой може да бъде и от дветехомоепитаксиален (като Si/Si)или хетероепитаксиални (като SiGe/Si или SiC/Si). Използват се различни методи за епитаксиален растеж, включително епитаксия с молекулярни лъчи (MBE), химическо отлагане на пари в ултрависок вакуум (UHV/CVD), епитаксия при атмосферно и намалено налягане (ATM & RP Epi). Тази статия се фокусира върху процесите на епитаксия на силиций (Si) и силиций-германий (SiGe), широко използвани в производството на полупроводникови интегрални схеми със силиций като субстратен материал.
1.2 Предимства на SiGe епитаксия:
Включване на определена част от германий (Ge) по време напроцес на епитаксияобразува SiGe монокристален слой, който не само намалява ширината на забранената лента, но също така увеличава граничната честота на транзистора (fT). Това го прави широко приложим във високочестотни устройства за безжични и оптични комуникации. Освен това, в усъвършенстваните процеси на CMOS интегрална схема, несъответствието на решетката (около 4%) между Ge и Si въвежда напрежение в решетката, повишавайки мобилността на електрони или дупки и по този начин увеличавайки тока на насищане на устройството и скоростта на реакция.
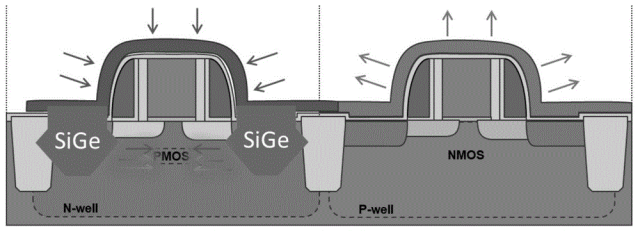
Изчерпателният процес на SiGe епитаксия
2.1 Предварителна обработка:
Силиконовите пластини се обработват предварително въз основа на желаните резултати от процеса, включващи основно отстраняване на естествения оксиден слой и примесите по повърхността на пластината. За силно легирани субстратни пластини е от решаващо значение да се прецени дали е необходимо обратно запечатване, за да се намали автоматичното допингиране по време на последващиепитаксиален растеж.
2.2 Газове и условия за растеж:
Силициеви газове: Силан (SiH₄), дихлоросилан (DCS, SiH₂Cl₂) и трихлорсилан (TCS, SiHCl₃) са трите най-често използвани източника на силициев газ. SiH₄ е подходящ за нискотемпературни процеси на пълна епитаксия, докато TCS, известен с бързия си темп на растеж, се използва широко за получаване на дебелисиликонова епитаксияслоеве.
Германиев газ: Герман (GeH₄) е основният източник за добавяне на германий, използван заедно с източници на силиций за образуване на SiGe сплави.
Селективна епитаксия: Селективният растеж се постига чрез регулиране на относителните скорости наепитаксиално отлаганеи in situ ецване, използвайки хлорсъдържащ силициев газ DCS. Селективността се дължи на това, че адсорбцията на Cl атоми върху силициевата повърхност е по-малка от тази на оксиди или нитриди, което улеснява епитаксиалния растеж. SiH₄, без атоми Cl и с ниска енергия на активиране, обикновено се прилага само за процеси на пълна епитаксия при ниска температура. Друг често използван източник на силиций, TCS, има ниско налягане на парите и е течен при стайна температура, което изисква барботиране на H₂, за да се въведе в реакционната камера. Въпреки това, той е сравнително евтин и често се използва поради бързата си скорост на растеж (до 5 μm/min) за отглеждане на по-дебели силициеви епитаксилни слоеве, широко прилагани в производството на силициеви епитаксиални пластини.
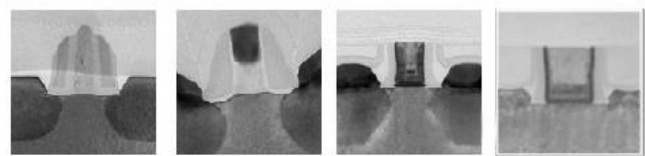
Напрегнат силиций в епитаксиални слоеве
По време наепитаксиален растеж, епитаксиален монокристален Si се отлага върху отпуснат SiGe слой. Поради несъответствието на решетката между Si и SiGe, монокристалният Si слой е подложен на напрежение на опън от долния слой SiGe, което значително повишава подвижността на електроните в NMOS транзисторите. Тази технология не само увеличава тока на насищане (Idsat), но също така подобрява скоростта на реакция на устройството. За PMOS устройства, слоевете SiGe се отглеждат епитаксиално в областите на източника и дренажа след ецване, за да се въведе напрежение на натиск върху канала, подобрявайки подвижността на отворите и увеличавайки тока на насищане.
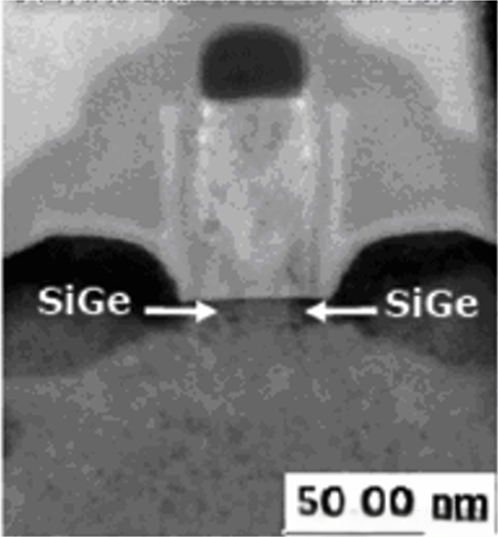
SiGe като жертвен слой в GAA структури
При производството на Gate-All-Around (GAA) нанопроводникови транзистори SiGe слоевете действат като жертвени слоеве. Техниките за анизотропно ецване с висока селективност, като например ецване на квазиатомни слоеве (квази-ALE), позволяват прецизно отстраняване на SiGe слоеве за образуване на нанопроводникови или нанолистови структури.
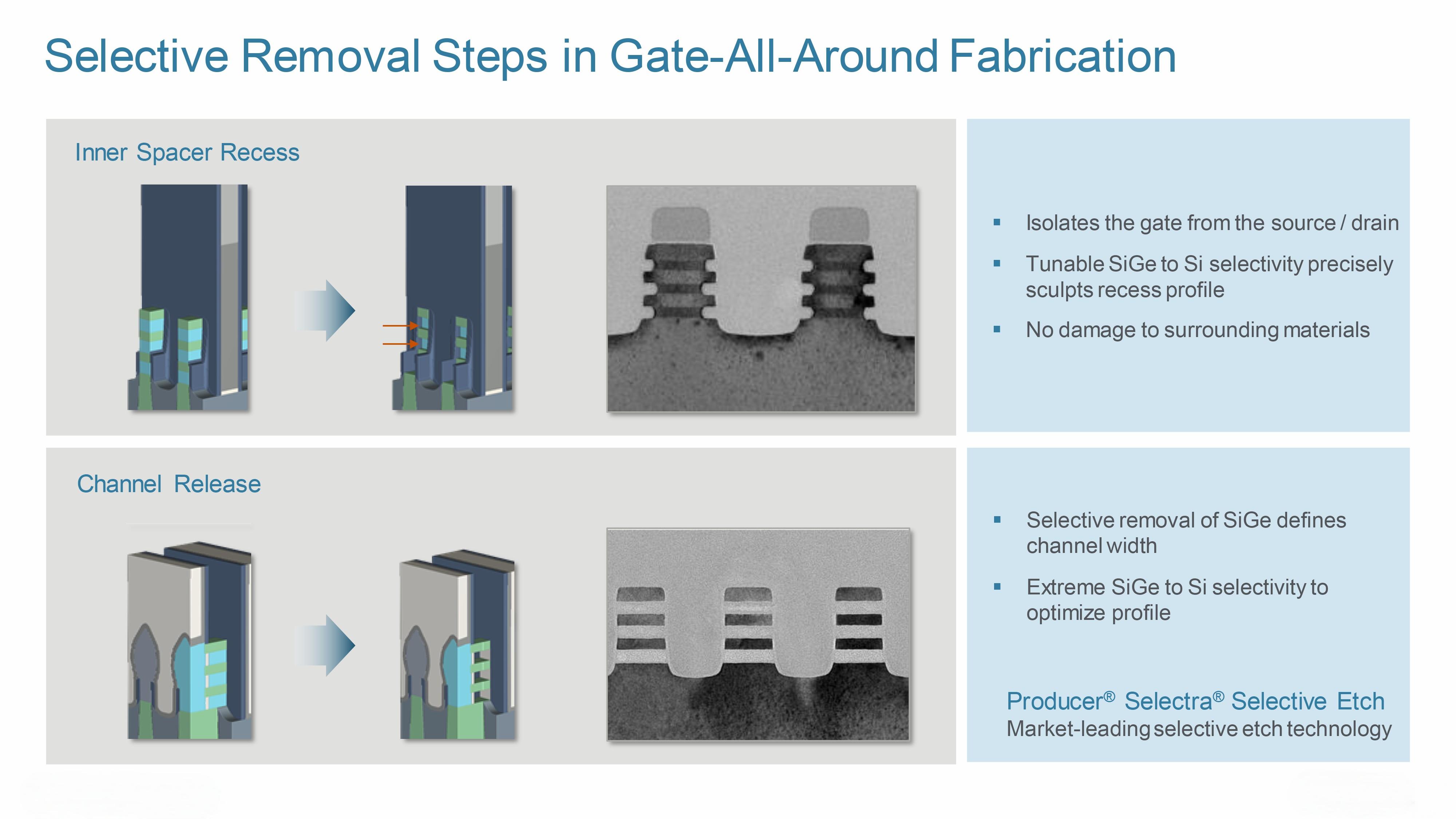
Ние от Semicorex сме специализирани вГрафитни разтвори с покритие от SiC/TaCприложен в Si епитаксиален растеж в производството на полупроводници, ако имате някакви запитвания или се нуждаете от допълнителни подробности, моля, не се колебайте да се свържете с нас.
Телефон за връзка: +86-13567891907
Имейл: sales@semicorex.com




