
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Разбиране на пълния процес на производство на полупроводникови устройства
1. Фотолитография
Фотолитографията, често синоним на генериране на шаблони, е една от най-важните движещи сили зад бързия напредък на полупроводниковата технология, произхождаща от процесите на производство на фотографски плаки в печата. Тази техника позволява представянето на всеки модел в микро или нано мащаб с помощта на фоторезист и когато се комбинира с други технологични процеси, пренася тези модели върху материали, реализирайки различни дизайни и концепции на полупроводникови материали и устройства. Източникът на светлина, използван във фотолитографията, влияе пряко върху прецизността на шаблоните, с опции, вариращи от ултравиолетови, дълбоки ултравиолетови до рентгенови и електронни лъчи, всеки от които съответства на нарастващи нива на прецизност на шаблона в посочения ред.
Стандартният процес на фотолитография включва подготовка на повърхността, адхезия, меко изпичане, експониране, изпичане след експониране, проявяване, твърдо изпичане и проверка.
Повърхностната обработка е наложителна, тъй като субстратите обикновено абсорбират H2O молекули от въздуха, което е вредно за фотолитографията. Следователно субстратите първоначално се подлагат на дехидратираща обработка чрез изпичане.
За хидрофилни субстрати, тяхната адхезия към хидрофобен фоторезист е недостатъчна, което потенциално причинява отлепване на фоторезиста или разместване на модела, поради което е необходим промотор на адхезията. Понастоящем хексаметил дисилазан (HMDS) и три-метил-силил-диетил-амин (TMSDEA) са широко използвани подобрители на адхезията.
След повърхностната обработка започва нанасянето на фоторезист. Дебелината на нанесения фоторезист е свързана не само с неговия вискозитет, но също така се влияе от скоростта на центрофугиране, обикновено обратно пропорционална на корен квадратен от скоростта на центрофугиране. След нанасяне на покритие се провежда меко изпичане, за да се изпари разтворителят от фоторезиста, подобрявайки адхезията в процес, известен като предварително изпичане.
След като тези стъпки са завършени, експозицията се извършва. Фоторезистите се класифицират като положителни или отрицателни, с противоположни свойства след излагане.
Вземете положителния фоторезист като пример, където неекспонираният фоторезист е неразтворим в проявителя, но става разтворим след излагане. По време на експозицията източникът на светлина, преминавайки през шарена маска, осветява покрития субстрат, оформяйки фоторезиста. Обикновено субстратът трябва да бъде подравнен с маската преди експониране, за да се контролира прецизно позицията на експониране. Продължителността на експозицията трябва да се управлява стриктно, за да се предотврати изкривяване на модела. След експозицията може да се наложи допълнително изпичане за смекчаване на ефектите от стояща вълна, въпреки че тази стъпка не е задължителна и може да бъде заобиколена в полза на директното развитие. Проявяването разтваря експонирания фоторезист, пренасяйки модела на маската точно върху слоя фоторезист. Времето за разработка също е критично - твърде краткото води до непълно развитие, твърде дългото причинява изкривяване на модела.
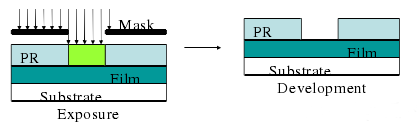
Впоследствие силното изпичане укрепва закрепването на фоторезистния филм към субстрата и подобрява неговата устойчивост на ецване. Температурата на твърдо изпичане обикновено е малко по-висока от тази на предварителното изпичане.
И накрая, микроскопската проверка проверява дали моделът отговаря на очакванията. След като моделът се пренесе върху материала чрез други процеси, фоторезистът е изпълнил целта си и трябва да бъде отстранен. Методите за оголване включват мокро (използване на силни органични разтворители като ацетон) и сухо (използване на кислородна плазма за ецване на филма).
2. Допинг техники
Допингът е незаменим в полупроводниковата технология, като променя електрическите свойства на полупроводниковите материали, ако е необходимо. Общите методи за допинг включват термична дифузия и йонна имплантация.
(1) Йонна имплантация
Йонната имплантация легира полупроводниковия субстрат, като го бомбардира с високоенергийни йони. В сравнение с термичната дифузия има много предимства. Йоните, избрани от масов анализатор, осигуряват висока чистота на допинг. По време на имплантирането субстратът остава на стайна температура или малко по-висока. Могат да се използват много маскиращи филми, като силициев диоксид (SiO2), силициев нитрид (Si3N4) и фоторезист, осигуряващи висока гъвкавост с техники за самоподравняващи се маски. Дозите на имплантите се контролират прецизно и разпределението на имплантираните йони на примеси е равномерно в една и съща равнина, което води до висока повторяемост.
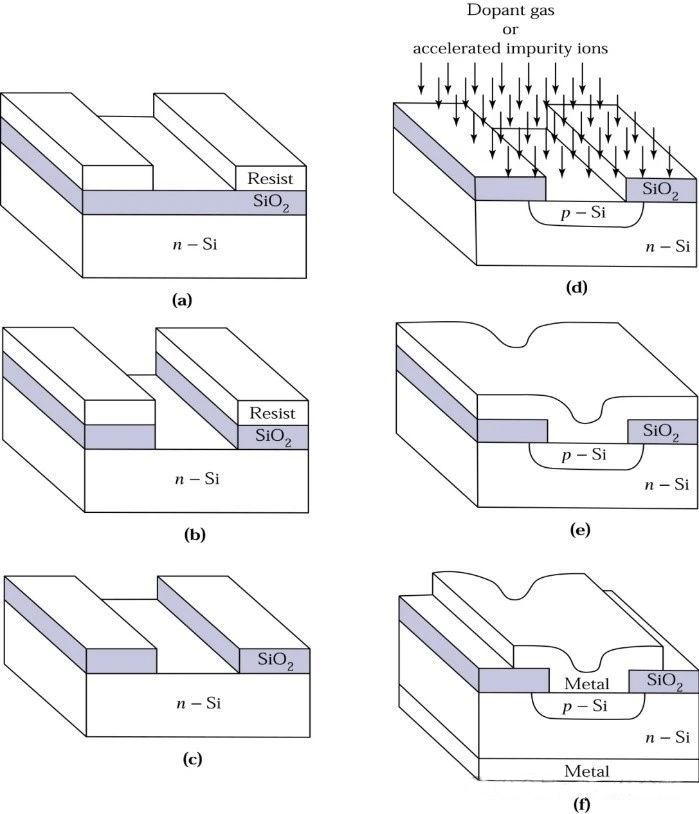
Дълбочината на имплантиране се определя от енергията на йоните. Чрез регулиране на енергията и дозата, разпределението на примесните йони в субстрата след имплантиране може да се манипулира. Множество имплантации с разнообразни схеми могат да се извършват непрекъснато, за да се постигнат различни профили на примеси. Трябва да се отбележи, че в монокристални субстрати, ако посоката на имплантиране е успоредна на кристалографската посока, възникват ефекти на канализиране - някои йони ще пътуват по канали, което прави контрола на дълбочината предизвикателство.
За да се предотврати канализирането, имплантирането обикновено се извършва под ъгъл от около 7° спрямо главната ос на монокристалния субстрат или чрез покриване на субстрата с аморфен слой.
Но имплантирането на йони може значително да увреди кристалната структура на субстрата. Високоенергийните йони, при сблъсък, пренасят енергия към ядрата и електроните на субстрата, карайки ги да напуснат решетката и да образуват двойки дефект между звена и свободни места. В тежки случаи кристалната структура в някои региони може да бъде разрушена, образувайки аморфни зони.
Повредата на решетката значително влияе върху електрическите свойства на полупроводниковия материал, като например намаляване на подвижността на носителите или живота на неравновесните носители. Най-важното е, че по-голямата част от имплантираните примеси заемат неправилни интерстициални места, като не успяват да образуват ефективен допинг. Следователно ремонтът на повредата на решетката след имплантиране и електрическото активиране на примесите са от съществено значение.
(2)Бърза термична обработка (RTP)
Термичното отгряване е най-ефективният метод за коригиране на увреждането на решетката, причинено от имплантиране на йони и електрически активиращи примеси. При високи температури двойките дефекти интерстициална ваканция в кристалната решетка на субстрата ще се рекомбинират и ще изчезнат; аморфните области също ще рекристализират от границата с монокристални области чрез твърдофазна епитаксия. За да се предотврати окисляването на материала на субстрата при високи температури, термичното отгряване трябва да се проведе във вакуум или атмосфера на инертен газ. Традиционното отгряване отнема много време и може да причини значително преразпределение на примеси поради дифузия.
Появата наRTP технологияразглежда този проблем, като до голяма степен постига възстановяване на повреда на решетката и активиране на примеси в рамките на съкратена продължителност на отгряване.
В зависимост от източника на топлина,RTPсе категоризира в няколко вида: сканиране с електронен лъч, импулсни електронни и йонни лъчи, импулсни лазери, лазери с непрекъсната вълна и широколентови некохерентни източници на светлина (халогенни лампи, графитни нагреватели, дъгови лампи), като последните са най-широко използвани. Тези източници могат да загреят субстрата до необходимата температура за миг, завършвайки отгряването за кратко време и ефективно намалявайки дифузията на примеси.
3. Техники за отлагане на филм
(1) Плазмено усилено химическо отлагане на пари (PECVD)
PECVD е една форма на техника за химическо отлагане на пари (CVD) за отлагане на филм, като другите две са CVD при атмосферно налягане (APCVD) и CVD при ниско налягане (LPCVD).
В момента PECVD е най-широко прилаганият сред трите типа. Той използва радиочестотна (RF) плазма за иницииране и поддържане на химически реакции при относително ниски температури, като по този начин улеснява нискотемпературното отлагане на филм с високи скорости на отлагане. Схемата на оборудването му е както е показано.
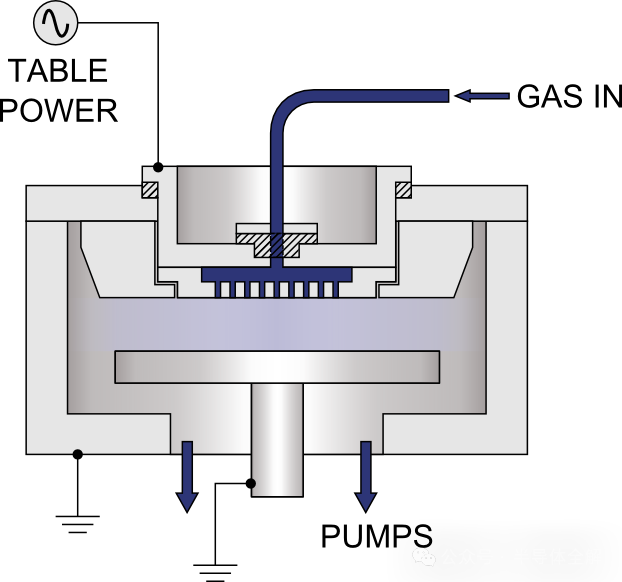
Филмите, произведени чрез този метод, показват изключителна адхезия и електрически свойства, минимална микропорьозност, висока еднородност и здрави възможности за запълване в малък мащаб. Факторите, влияещи върху качеството на PECVD отлагането, включват температура на субстрата, скорост на газовия поток, налягане, RF мощност и честота.
(2) Разпръскване
Разпрашването е метод на физическо отлагане на пари (PVD). Заредените йони (обикновено аргонови йони, Ar+) се ускоряват в електрическо поле, придобивайки кинетична енергия. Те се насочват към целевия материал, сблъскват се с целевите молекули и ги карат да се изместят и да се разпръснат. Тези молекули също притежават значителна кинетична енергия и се придвижват към субстрата, отлагайки се върху него.

Обикновено използваните източници на енергия за разпръскване включват постоянен ток (DC) и радиочестота (RF), където разпръскването с постоянен ток е пряко приложимо към проводящи материали като метали, докато изолационните материали изискват RF разпръскване за отлагане на филм.
Конвенционалното разпрашване страда от ниски скорости на отлагане и високи работни налягания, което води до по-ниско качество на филма. Магнетронното разпрашаване се справя по-идеално с тези проблеми. Той използва външно магнитно поле, за да промени линейната траектория на йоните до спираловидна пътека около посоката на магнитното поле, удължавайки пътя им и подобрявайки ефективността на сблъсък с целевите молекули, като по този начин повишава ефективността на разпръскване. Това води до повишени скорости на отлагане, намалено работно налягане и значително подобрено качество на филма.
4. Офорт Техники
Офортът се класифицира на сух и мокър режим, наречен съответно поради използването (или липсата) на специфични решения.
Обикновено ецването изисква подготовката на маскиращ слой (който може директно да бъде фоторезист), за да защити областите, които не са предназначени за ецване.
(1) Сухо ецване
Обичайните видове сухо ецване включватОфорт с индуктивно свързана плазма (ICP)., Йонно лъчево ецване (IBE) и Реактивно йонно ецване (RIE).
При ICP ецване плазмата, произведена от тлеещ разряд, съдържа множество високо химически активни свободни радикали (свободни атоми, молекули или атомни групи), които реагират химически с целевия материал, за да образуват летливи продукти, като по този начин постигат ецване.
IBE използва високоенергийни йони (йонизирани от инертни газове) за директно бомбардиране на повърхността на целевия материал за ецване, което представлява физически процес.
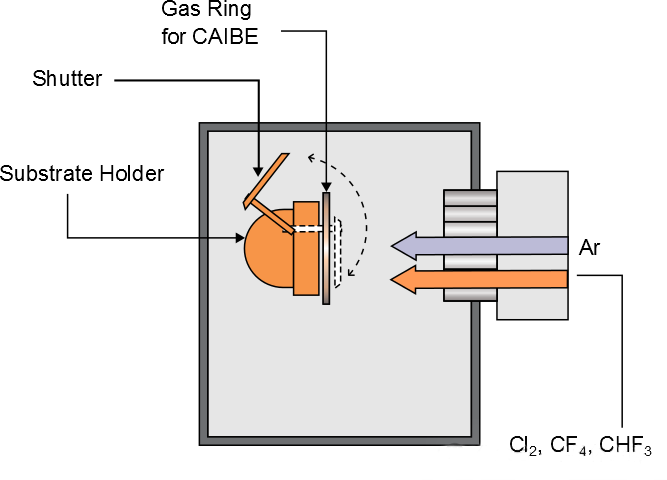
RIE се счита за комбинация от предишните две, заменяйки инертния газ, използван в IBE, с газа, използван при ICP ецване, като по този начин представлява RIE.
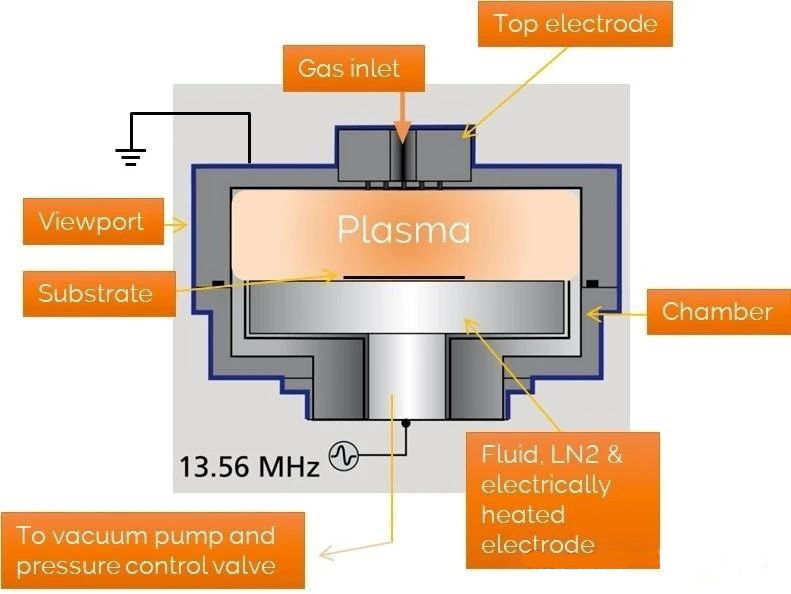
За сухо ецване скоростта на вертикално ецване далеч надвишава страничната скорост, т.е. има високо аспектно съотношение, което позволява прецизно копиране на шаблона на маската. Въпреки това, сухото ецване също ецва слоя маска, показвайки по-лоша селективност (съотношението на скоростта на ецване на целевия материал към слоя маска), особено с IBE, което може да ецва неселективно върху повърхността на материала.
(2) Мокро ецване
Мокрото ецване означава метод на ецване, постигнат чрез потапяне на целевия материал в разтвор (ецващ препарат), който химически реагира с него.
Този метод на ецване е прост, рентабилен и показва добра селективност, но има ниско аспектно съотношение. Материалът под ръбовете на маската може да бъде корозирал, което го прави по-малко прецизен от сухото ецване. За да се смекчат отрицателните въздействия на ниското съотношение на страните, трябва да се изберат подходящи скорости на ецване. Факторите, влияещи върху скоростта на ецване, включват концентрация на ецващ агент, време на ецване и температура на ецващ агент.**




