
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Плазмени процеси при CVD операции
1. Почистване на камерата
По време на процеса на химическо отлагане на пари (CVD) се образуват отлагания не само върху повърхността на пластината, но и върху компонентите в камерата за обработка и нейните стени. Филмите, отложени върху частите, трябва редовно да се отстраняват, за да се поддържат стабилни условия на процеса и да се предотврати замърсяване на пластините с частици. Повечето CVD камери използват химически реакционни газове на основата на флуор за почистване.
В CVD камерите със силициев оксид плазменото почистване обикновено включва флуоровъглеродни газове като CF4, C2F6 и C3F8, които се разлагат в плазмата, освобождавайки флуорни радикали. Химичните реакции са представени, както следва:
·e- + CF4 -> CF3 + F + e-
· e- + C2F6 -> C2F5 + F + e-
Флуорните атоми, които са сред най-реактивните радикали, бързо реагират със силициев оксид, за да образуват газообразен SiF4, който може лесно да бъде евакуиран от камерата:
·F + SiO2 -> SiF4 + O2 + други летливи странични продукти
Волфрамовите CVD камери обикновено използват SF6 и NF3 като източници на флуор. Флуорните радикали реагират с волфрам, за да произведат летлив волфрамов хексафлуорид (WF6), който може да бъде евакуиран от камерата чрез вакуумни помпи. Почистването на плазмената камера може да бъде прекратено автоматично чрез наблюдение на емисионните характеристики на флуор в плазмата, като се избягва прекомерното пречистване на камерата. Тези аспекти ще бъдат обсъдени по-подробно.
2. Запълване на празнини
Когато празнината между металните линии се стесни до 0,25 µm с аспектно съотношение 4:1, повечето CVD техники за отлагане се борят да запълнят празнините без кухини. Плазмената CVD с висока плътност (HDP-CVD) е в състояние да запълни такива тесни празнини, без да създава кухини (вижте фигурата по-долу). HDP-CVD процесът ще бъде описан по-късно.
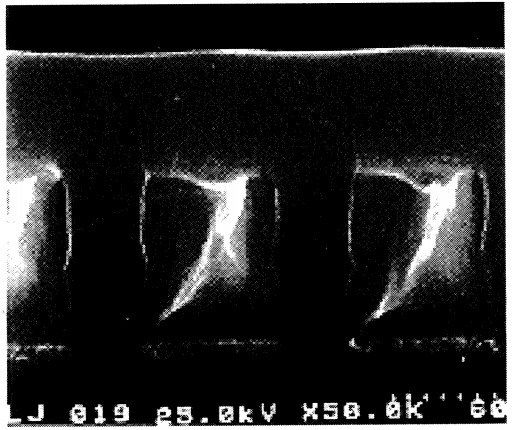
3. Плазмено ецване
В сравнение с мокрото ецване, плазменото ецване предлага предимства като анизотропни профили на ецване, автоматично откриване на крайна точка и по-ниска консумация на химикали, заедно с разумно високи скорости на ецване, добра селективност и еднородност.
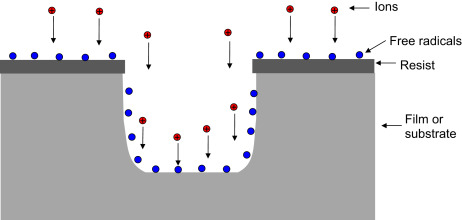
4. Контрол на Etch Profiles
Преди плазменото ецване да стане широко разпространено в производството на полупроводници, повечето производители на пластини са използвали мокро химическо ецване за трансфер на модел. Мокрото ецване обаче е изотропен процес (ецване с еднаква скорост във всяка посока). Когато размерите на елементите се свият под 3 µm, изотропното ецване води до подрязване, което ограничава приложението на мокрото ецване.
При плазмените процеси йоните непрекъснато бомбардират повърхността на пластината. Независимо дали чрез механизми за увреждане на решетката или механизми за пасивиране на страничната стена, плазменото ецване може да постигне анизотропни профили на ецване. Чрез намаляване на налягането по време на процеса на ецване, средният свободен път на йони може да бъде увеличен, като по този начин се намаляват йонните сблъсъци за по-добър контрол на профила.
5. Скорост на ецване и селективност
Йонното бомбардиране в плазмата помага за разрушаването на химическите връзки на повърхностните атоми, излагайки ги на радикали, генерирани от плазмата. Тази комбинация от физическа и химическа обработка значително повишава скоростта на химическата реакция на ецване. Скоростта на ецване и селективността се определят от изискванията на процеса. Тъй като както йонното бомбардиране, така и радикалите играят решаваща роля в ецването и RF мощността може да контролира йонното бомбардиране и радикалите, RF мощността се превръща в ключов параметър за контролиране на скоростта на ецване. Увеличаването на радиочестотната мощност може значително да повиши скоростта на ецване, което ще бъде обсъдено по-подробно, също засягайки селективността.
6. Откриване на крайна точка
Без плазма, крайната точка на ецване трябва да се определи чрез време или визуална инспекция на оператора. При плазмени процеси, докато ецването напредва през повърхностния материал, за да започне ецване на основния (крайна точка) материал, химическият състав на плазмата се променя поради промяната в страничните продукти на ецването, очевидно чрез промяна в цвета на емисиите. Чрез наблюдение на промяната в цвета на емисиите с оптични сензори, крайната точка на ецване може да бъде обработена автоматично. В производството на IC това е много ценен инструмент.**




