
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Представяне на физическия транспорт на парите (PVT)
Собствените характеристики на SiC определят, че неговият монокристален растеж е по-труден. Поради отсъствието на Si:C=1:1 течна фаза при атмосферно налягане, по-зрелият процес на растеж, възприет от основния поток на полупроводниковата индустрия, не може да се използва за отглеждане на по-зрелия метод на растеж - метод на право издърпване, низходящ тигел метод и други методи за растеж. След теоретични изчисления, само когато налягането е по-голямо от 105 atm и температурата е по-висока от 3200 ℃, можем да получим стехиометричното съотношение на Si:C = 1:1 разтвор. pvt методът в момента е един от най-масовите методи.
Методът PVT има ниски изисквания за оборудване за растеж, прост и контролируем процес, а развитието на технологиите е относително зряло и вече е индустриализирано. Структурата на метода PVT е показана на фигурата по-долу.
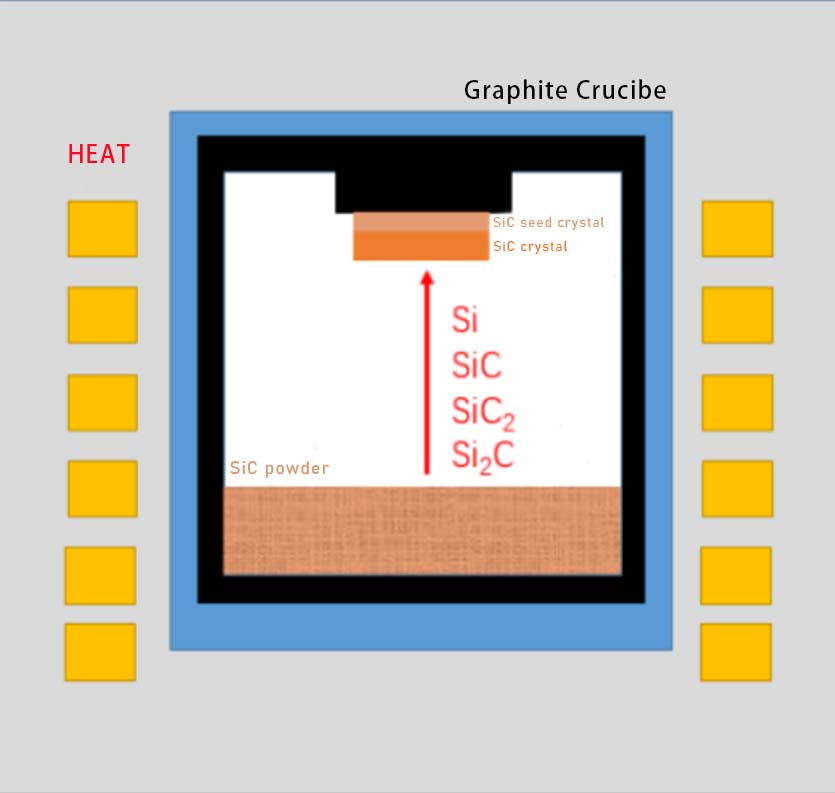
Регулирането на аксиалното и радиалното температурно поле може да се осъществи чрез контролиране на външното състояние на запазване на топлината на графитния тигел. SiC прахът се поставя на дъното на графитния тигел с по-висока температура, а SiC зародишният кристал се фиксира в горната част на графитния тигел с по-ниска температура. Разстоянието между праха и зародишните кристали обикновено се контролира да бъде десетки милиметри, за да се избегне контакт между растящия монокристал и праха.
Температурният градиент обикновено е в диапазона 15-35°C/cm интервал. Инертен газ под налягане 50-5000 Ра се задържа в пещта за увеличаване на конвекцията. SiC прахът се нагрява до 2000-2500°C чрез различни методи на нагряване (индукционно нагряване и съпротивително нагряване, съответното оборудване е индукционна пещ и съпротивителна пещ), а суровият прах сублимира и се разлага на компоненти в газова фаза като Si, Si2C , SiC2 и т.н., които се транспортират до края на зародишния кристал с газова конвекция, а кристалите SiC кристализират върху зародишните кристали, за да се постигне растеж на единичен кристал. Типичната му скорост на растеж е 0,1-2 mm/h.
Понастоящем методът PVT е разработен и узрял и може да реализира масовото производство на стотици хиляди парчета годишно, а неговият размер на обработка е реализиран 6 инча и сега се развива до 8 инча, а има и свързани компании, използващи реализацията на 8-инчовите образци на чипове за субстрат. Методът PVT обаче все още има следните проблеми:
- Технологията за подготовка на SiC субстрат с големи размери е все още незряла. Тъй като методът PVT може да бъде само в надлъжна дълга дебелина, е трудно да се реализира напречното разширение. За да се получат пластини от SiC с по-голям диаметър, често трябва да се инвестират огромни суми пари и усилия, а с текущия размер на пластините от SiC продължава да се разширява, тази трудност само постепенно ще нараства. (Същото като развитието на Si).
- Текущото ниво на дефекти на SiC субстрати, отгледани по метода PVT, все още е високо. Дислокациите намаляват блокиращото напрежение и увеличават тока на утечка на SiC устройствата, което влияе върху приложението на SiC устройствата.
- Субстратите от P-тип са трудни за приготвяне чрез PVT. Понастоящем SiC устройствата са предимно еднополярни устройства. Бъдещите високоволтови биполярни устройства ще изискват p-тип субстрати. Използването на p-тип субстрат може да реализира растежа на N-тип епитаксиал, в сравнение с растежа на P-тип епитаксиал върху N-тип субстрат има по-висока мобилност на носителя, което може допълнително да подобри работата на SiC устройствата.




