
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Бездефектен епитаксиален растеж и неподходящи дислокации
Епитаксиален растеж без дефекти възниква, когато една кристална решетка има почти идентични константи на решетка с друга. Растеж се случва, когато местата на решетката на двете решетки в областта на интерфейса са приблизително съвпадащи, което е възможно при малко несъответствие на решетката (по-малко от 0,1%). Това приблизително съвпадение се постига дори при еластично напрежение на интерфейса, където всеки атом е леко изместен от първоначалната си позиция в граничния слой. Докато малко количество деформация е приемливо за тънки слоеве и дори е желателно за лазери с квантови ямки, енергията на деформация, съхранена в кристала, обикновено се понижава от образуването на несъответстващи дислокации, които включват липсващ ред от атоми в една решетка.

Фигурата по-горе илюстрира схема нанеподходяща дислокация, образувана по време на епитаксиален растеж върху кубична (100) равнина, където двата полупроводника имат малко различни константи на решетката. Ако a е константата на решетката на субстрата и a’ = a − Δa е тази на нарастващия слой, тогава разстоянието между всеки липсващ ред от атоми е приблизително:
L ≈ a2/Δa
На границата на двете решетки липсващите редове от атоми съществуват в две перпендикулярни посоки. Разстоянието между редовете по главните кристални оси, като [100], е приблизително дадено от горната формула.
Този тип дефект на интерфейса се нарича дислокация. Тъй като възниква от несъответствието на решетката (или несъответствието), то се нарича дислокация на несъответствието или просто дислокация.
В близост до неподходящи дислокации решетката е несъвършена с много висящи връзки, което може да доведе до нерадиационна рекомбинация на електрони и дупки. Следователно, за висококачествено производство на оптоелектронни устройства са необходими слоеве без дислокация на несъответствие.
Генерирането на несъответстващи дислокации зависи от несъответствието на решетката и дебелината на израсналия епитаксиален слой. Ако несъответствието на решетката Δa/a е в диапазона от -5 × 10-3 до 5 × 10-3, тогава не се образуват дислокации на несъответствие в InGaAsP-InP двойно хетероструктурни слоеве (с дебелина 0,4 µm), отгледани върху (100) InP.
Появата на дислокации като функция на несъответствието на решетката за различни дебелини на слоеве InGaAs, отглеждани при 650°C върху (100) InP, е показано на фигурата по-долу.
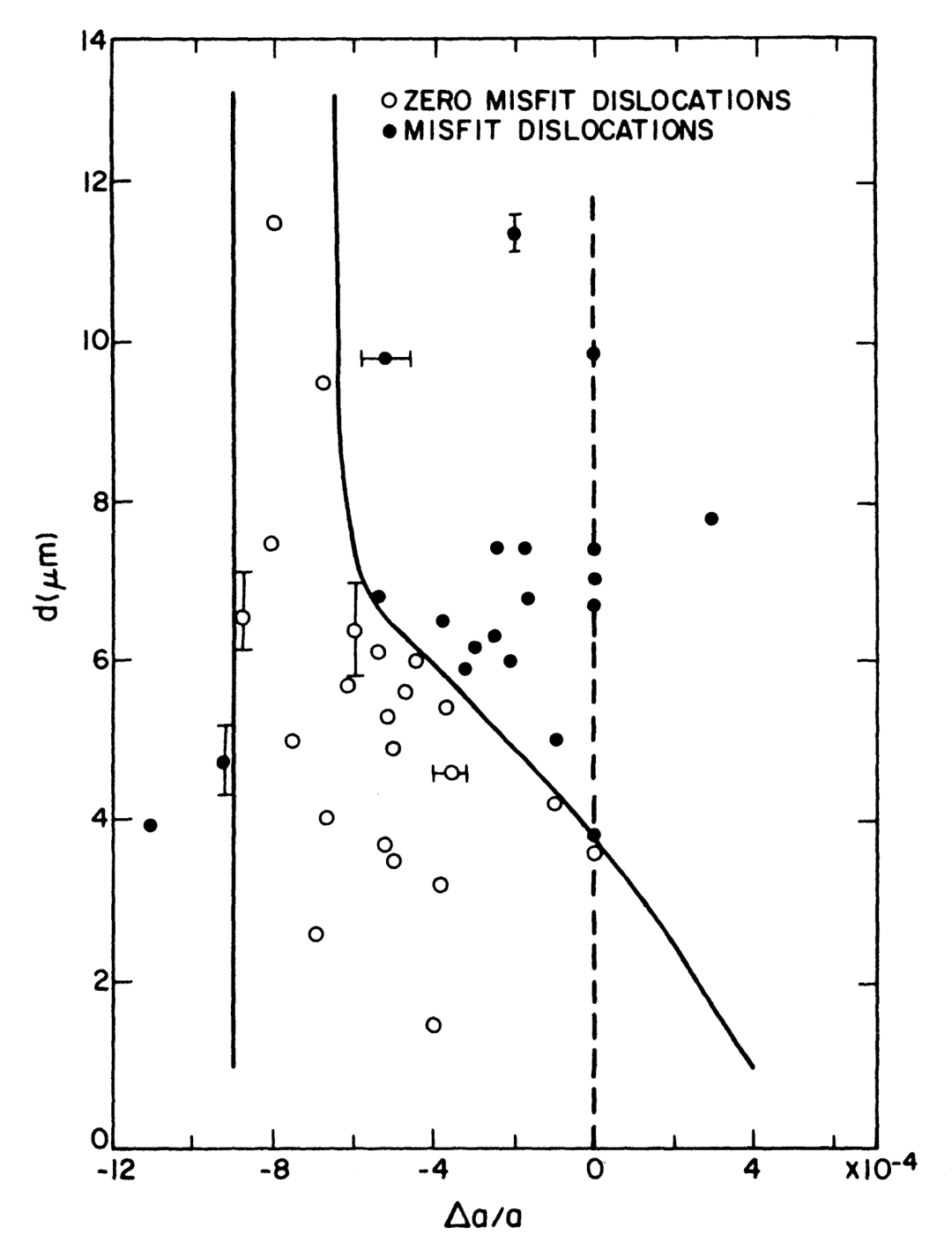
Тази фигура илюстрирапоявата на дислокации на несъответствие като функция на несъответствие на решетката за различни дебелини на слоеве InGaAs, отгледани чрез LPE върху (100) InP. Не се наблюдават дислокации на несъответствие в областта, ограничена от плътни линии.
Както е показано на фигурата по-горе, плътната линия представлява границата, където не са наблюдавани дислокации. За растежа на дебели слоеве InGaAs без дислокации е установено, че допустимото несъответствие на решетката при стайна температура е между -6,5 × 10-4 и -9 × 10-4 .
Това отрицателно несъответствие на решетката възниква поради разликата в коефициентите на топлинно разширение на InGaAs и InP; идеално съчетан слой при температура на растеж от 650°C ще има отрицателно несъответствие на решетката при стайна температура.
Тъй като дислокациите на несъответствие се образуват около температурата на растеж, съвпадението на решетката при температурата на растеж е важно за растежа на слоеве без дислокации.**




