
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Епитаксиални слоеве: Основата на модерните полупроводникови устройства
Фигура 1: Илюстрира корелацията между концентрациите на допинг, дебелината на слоя и пробивното напрежение за еднополярни устройства.

Подготовката на SiC епитаксиални слоеве основно обхваща техники като растеж чрез изпаряване, епитаксия в течна фаза (LPE), епитаксия с молекулярни лъчи (MBE) и химическо отлагане на пари (CVD), като CVD е преобладаващият метод за масово производство във фабриките.
Таблица 1: Предоставя сравнителен преглед на основните методи за подготовка на епитаксиален слой.

Един революционен подход включва растеж върху субстрати извън ос {0001} при определен ъгъл на наклон, както е показано на фигура 2(b). Този метод значително увеличава плътността на стъпките, като същевременно намалява размера на стъпките, улеснявайки нуклеацията предимно в местата на групиране на стъпки и по този начин позволявайки на епитаксиалния слой да възпроизведе перфектно последователността на подреждане на субстрата, елиминирайки съвместното съществуване на политипове.
Фигура 2: Демонстрира физическия процес на стъпаловидно контролирана епитаксия в 4H-SiC.
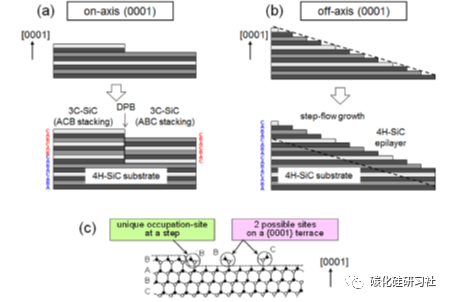
Фигура 3: Показва критичните условия за CVD растеж при стъпаловидно контролирана епитаксия за 4H-SiC.

Фигура 4: Сравнява скоростите на растеж при различни източници на силиций за 4H-SiC епитаксия.

В областта на приложенията с ниско и средно напрежение (напр. 1200V устройства), технологията за епитаксия на SiC е достигнала зрял етап, предлагайки относително превъзходна еднородност в дебелината, концентрацията на допинг и разпределението на дефектите, отговаряйки адекватно на изискванията за SBD с ниско и средно напрежение , MOS, JBS устройства и други.
Въпреки това областта с високо напрежение все още представлява значителни предизвикателства. Например, устройства, оценени на 10000 V, изискват епитаксиални слоеве с дебелина приблизително 100 μm, но тези слоеве показват значително по-лоша дебелина и еднородност на допинга в сравнение с техните колеги с ниско напрежение, да не говорим за вредното въздействие на триъгълните дефекти върху цялостната производителност на устройството. Приложенията с високо напрежение, които са склонни да предпочитат биполярни устройства, също поставят строги изисквания към живота на миноритарния носител, което налага оптимизиране на процеса за подобряване на този параметър.
В момента пазарът е доминиран от 4-инчови и 6-инчови SiC епитаксиални пластини, с постепенно увеличаване на дела на SiC епитаксиални пластини с голям диаметър. Размерът на SiC епитаксиалните пластини се определя основно от размерите на SiC субстратите. С 6-инчовите SiC субстрати, които вече са налични в търговската мрежа, преходът от 4-инчов към 6-инчов SiC епитаксия непрекъснато е в ход.
Тъй като технологията за производство на SiC субстрати напредва и производствените мощности се разширяват, цената на SiC субстрати прогресивно намалява. Като се има предвид, че субстратите представляват повече от 50% от цената на епитаксиалните пластини, намаляващите цени на субстрата се очаква да доведат до по-ниски разходи за SiC епитаксия, като по този начин обещават по-светло бъдеще за индустрията.**




